服务热线
导 读
Intel(英特尔)是半导体行业和创新领域的全球卓越厂商,致力于推动人工智能、5G、高性能计算等技术的创新和应用突破,驱动智能互联世界。 56年前,intel创始人之一的戈登·摩尔提出了摩尔定律 (Moore's Law),推动着集成电路产业一直发展到今天。 在先进封装领域,Intel依然是技术的领导者,创造性地推出了EMIB,Foveros,Co-EMIB,ODI等先进封装和互联技术,继续驱动着技术不断向前! 今天,我们有机会连线Intel封装研究与系统解决方案总监Johanna Swan院士,就先进封装技术进行深入的沟通和交流,学习先进封装最前沿的发展动态。 在个人电脑领域,Intel 当之无愧是最具创造力的公司,Intel inside深入人心,从奔腾到酷睿再到i3i5i7i9,人们如数家珍,每一款产品都带给人们全新的体验,推动着数字世界不断向前!
异构时代已然到来,Intel是否迸发出了新的创造力,又会带给世界什么样的新技术和产品?我们还是听听来自Intel的声音~
Suny Li ~1
首先,我们想请Swan院士谈一谈 Intel 在先进封装技术领域的研发规划和 最新的研究成果。Johanna Swan ~1
好的 ,我首先给大家分享 Intel 先进封装技术路线图,图中 X 轴代表功率效率, Y 轴代表互连密度,Z 轴则展示了我们的技术可扩展性。
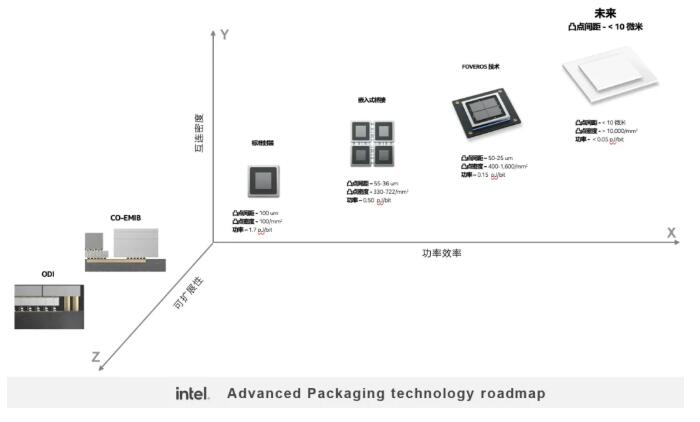
从标准封装,到嵌入式多芯片互联桥EMIB,更多的芯片被包含到封装中,凸点间距也越来越小,从100um变为55-36um。
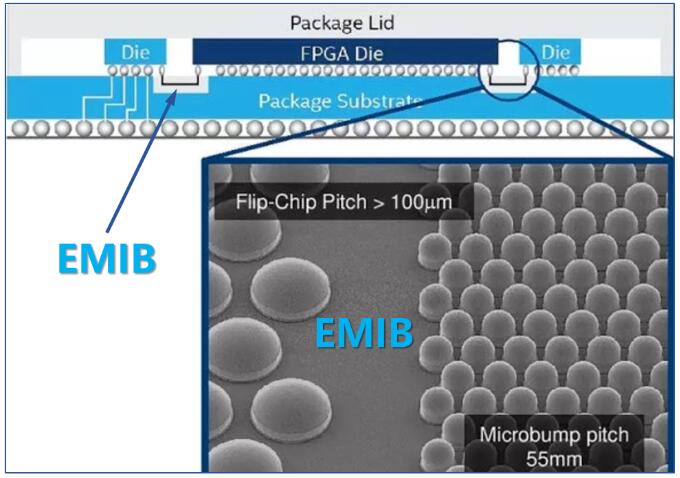
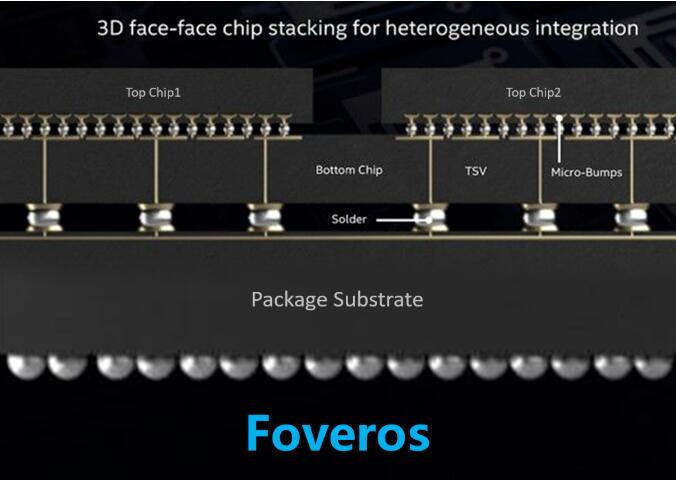
在今年 ECTC 上 Intel 发表了一篇关于混合键合技术的论文,这是一种在相互堆叠的芯片之间获得更密集互连的方法,并可实现更小的外形尺寸。下图左边的技术,被称为 Foveros,凸点间距是 50 微米,每平方毫米有大约 400 个凸点。对于未来, Intel 要做的是缩减到大约 10 微米的凸点间距,并达到每平方毫米 10,000 个凸点。
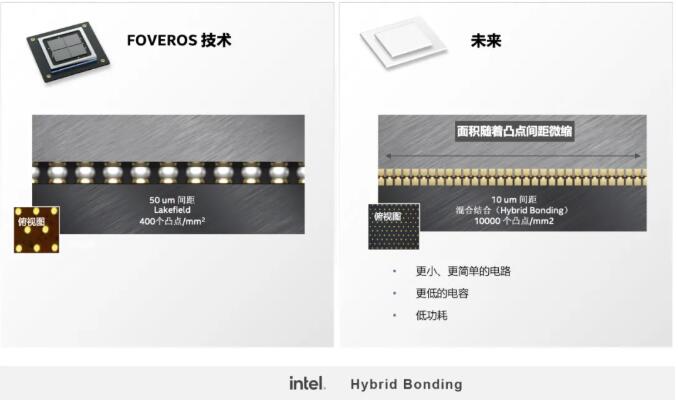
Hybrid Bonding 技术可以在芯片之间实现更多的互连,并带来更低的电容,降低每个通道的功率,并让我们朝着提供最好产品的方向发展。
下图是传统凸点焊接技术和Hybrid Bonding 混合键合技术的比较,混合键合技术需要新的制造、操作、清洁和测试方法。混合键合技术的优势包括:有更高的电流负载能力,可扩展的间距小于1微米,并且具有更好的热性能。
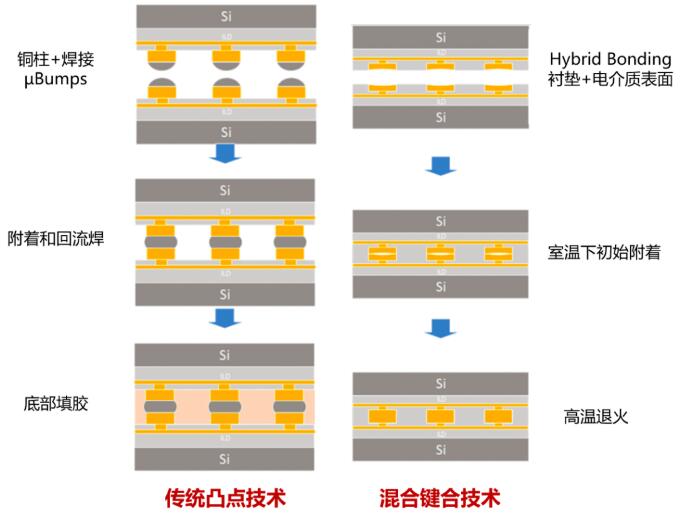
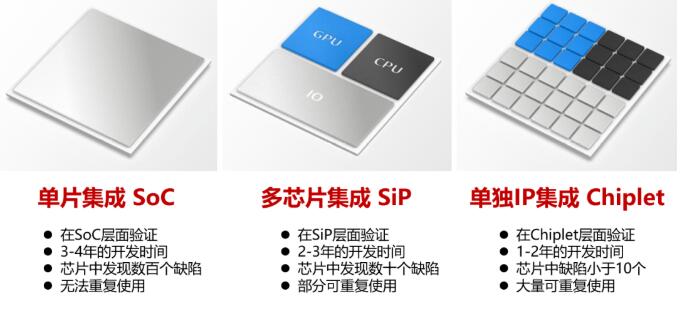
Chiplet 技术改变了芯片到芯片的互联, 更多的芯片间互联需要更高的互联密度,因此需要从传统的凸点焊接转向混合键合。
此外,我们面对另一个挑战,就是如何将这些芯片组装到一起,并保持制造流程以相同的速度进行。现在有更多的芯片需要放置,能否在一次只放置一个芯片的基础上以足够快的速度加工?解决方案是批量组装,我们称之为自组装Self-Assembly技术。
Intel 正在积极与法国原子能委员会电子与信息技术实验室 CEA-LETI 合作,研究一次能够放置多个芯片,同时进行确定性快速放置,拾取并放置更多芯片。
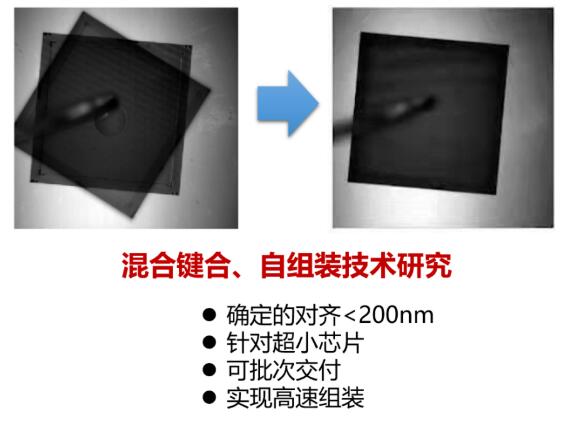
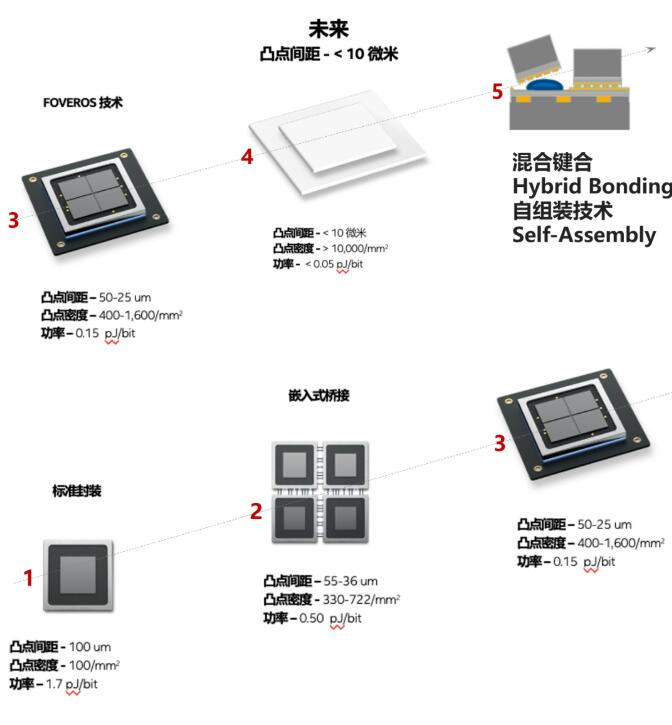
免责声明:本文转载自“SiP与先进封装技术”,本文仅代表作者个人观点,不代表萨科微及行业观点,只为转载与分享,支持保护知识产权,转载请注明原出处及作者,如有侵权请联系我们删除。
公司电话:+86-0755-83044319
传真/FAX:+86-0755-83975897
邮箱:1615456225@qq.com
QQ:3518641314 李经理
QQ:332496225 丘经理
地址:深圳市龙华新区民治大道1079号展滔科技大厦C座809室








 粤公网安备44030002007346号
粤公网安备44030002007346号